專注于工業CT檢測\失效分析\材料檢測分析的第三方實驗室
公正高效 \ 精準可靠 \ 費用合理

芯片開封對于失效模式鑒定起著重要的作用。通過開封芯片,可以觀察和分析芯片內部的結構、元件連接、電路布局等信息,從而揭示可能導致芯片失效的具體原因。以下是在芯片開封中常見的失效模式鑒定方法:
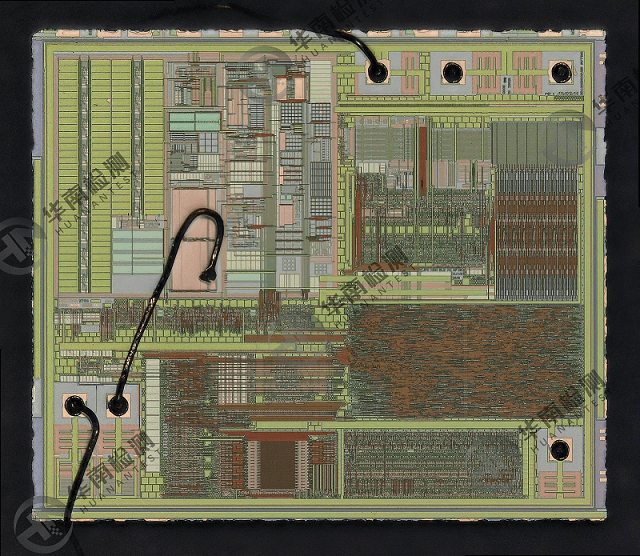
物理檢查:通過對開封后的芯片進行物理檢查,包括觀察芯片內部元件的形狀、尺寸、材料等信息,以鑒定是否存在物理損傷、元件缺陷或熱應力引起的問題。
金屬線連接分析:觀察芯片內部的金屬線連接情況,檢查焊接質量、金屬線斷裂、短路等問題,以確定是否存在金屬線相關的失效模式。
襯底電路和電源分析:通過觀察芯片襯底電路和電源結構,檢查是否存在電源噪聲、電源供電不良、襯底偏壓異常等問題,以鑒定是否存在相關失效模式。
硅膜和介電層分析:觀察芯片內部的硅膜和介電層的狀況,檢查是否存在漏電、擊穿、介電層缺陷等問題,以確定是否存在與硅膜和介電層相關的失效模式。
元件級別分析:對芯片內部元件進行詳細檢查和分析,包括觀察元件的結構、材料、尺寸等信息,以鑒定是否存在元件本身的質量問題或損傷導致的失效。
通過以上分析方法,可以識別潛在的失效模式,確定芯片故障的根本原因。這有助于進一步改進產品設計、制造和可靠性,提高芯片的性能和可靠性。需要注意的是,芯片開封是破壞性操作,一旦開封后的芯片無法再使用,因此在進行芯片開封前需要仔細考慮和評估
華南檢測技術專注工業CT 檢測、失效分析、材料分析檢測、芯片鑒定、芯片線路修改、晶圓微結構分析、可靠性檢測、逆向工程、微納米測量等專業技術測服務,歡迎前來咨詢了解,客服咨詢熱線:13926867016。



 粵公網安備 44190002006902號
備案號: 粵ICP備2022048342 版權所有:廣東省華南檢測技術有限公司 Guangdong South China Testing Technology Co., LTD
粵公網安備 44190002006902號
備案號: 粵ICP備2022048342 版權所有:廣東省華南檢測技術有限公司 Guangdong South China Testing Technology Co., LTD