FIB制樣介紹
————————————————————————————————————————————————————
FIB基本原理 FIB(Focused Ion Beam,聚焦離子束)是將離子源(如鎵)產生的離子束經過離子槍加速,并利用電透鏡聚焦成非常小尺寸(納米級)的顯微切割儀器。可以實現微、納米級尺度的表面形貌加工。通常會配置高分辨的掃描電鏡(SEM),用于切割位置的定位及新鮮截面的成像,也就是常說的雙束FIB。 | 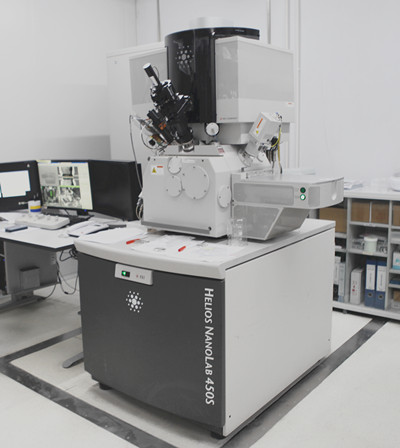 |
FIB設備介紹
————————————————————————————————————————————————————
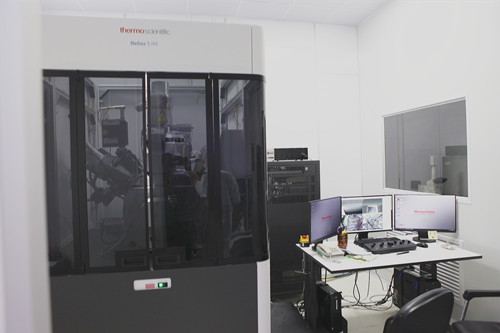 | FIB優勢 FIB是最精密,最微細的加工方法之一, 是微納 米加工技術的基礎; 污染少,特別適用于對易氧化的金屬、 合金材料合高純度半導體材料的加工; 無加工應力,熱變形等級小,加工質量高, 適合于對各種材料或零件的加工。
主要參數 FIB (Ion Beam) 30KV 1.1pA,≤4nm 500V,97pA,≤500nm SEM (E Beam) TLD, UC-mode ON, 1 kV, WD=1.5~2mm,1.6~6.3 pA Measured value ≤0.7 nm |
FIB基本應用
————————————————————————————————————————————————————
| 集成電路的診斷與修改 |
|
Cross-section截面制備 |
|
| 制作透射電鏡樣品 |
|
FIB應用示例
————————————————————————————————————————————————————