 您當前的位置:
您當前的位置: 電子元器件破壞性物理分析(DPA)介紹
———————————————————————————————————————————————————————————
破壞性物理分析,英文Destructive Physical Analysis,縮寫即DPA。它是在元器件的生產批隨機抽取適當數量的樣品,采用一系列非破壞和破壞性的方法來檢驗元器件的設計、結構、材料、制造質量是否滿足預定用途及相關規范要求。
根據DPA結果剔除不合格批次,保留合格批次。破壞性物理分析(DPA)是高可靠工程使用的元器件質量保證重要方法之一,主要用于元器件批質量的評價,也適用于元器件生產過程中的質量監控。 DPA可發現在常規篩選檢驗中不一定能暴露的問題,這些問題主要是與產品設計、結構、裝配等工藝相關的缺陷。由于破壞性物理分析技術有這樣的技術特點,因此,對軍用電子元器件開展DPA,可以把問題暴露于事前,有效防止型號工程由于電子元器件的潛在質量問題而導致整體失效。
對于DPA中暴露的問題,只要元器件承制廠所與DPA實驗室緊密結合,進行分析與跟蹤,準確找出導致缺陷產生的原因,采取有針對性的整改措施,則大多數缺陷模式是可以得到控制或消除的。
破壞性物理分析(DPA)技術不但適用于軍用電子元器件,而且也同樣適用于民用電子元器件,如采購檢驗、進貨驗貨及生產過程中的質量監測等均可應用DPA技術。
電子元器件破壞性物理分析(DPA)分析范圍
———————————————————————————————————————————————————————————
電阻器;電容器;磁珠;電感器;變壓器;晶體振蕩器;晶體諧振器;繼電器;
半導體分立器件(二極管、三極管、場效應管、達林頓陣列、半導體光電子器件等);
電連接器;開關及面板元件;半導體集成電路(時基電路、總線收發器、緩沖器、驅動器、電平轉換器、門器件、觸發器、LVDS線收發器、運算放大器、電壓調整器、電壓比較器、電源類芯片(穩壓器、開關電源轉換器、電源監控器、電源管理等)、數模轉換器(A/D、D/A、SRD)、存儲器、可編程邏輯器件、單片機、微處理器、控制器等);濾波器;電源模塊;IGBT等。
電子元器件破壞性物理分析(DPA)檢測項目
———————————————————————————————————————————————————————————

電子元器件破壞性物理分析(DPA)應用示例
———————————————————————————————————————————————————————————
外部目檢:外觀鏡檢的目的是確認封裝工藝是否有異常,亦可用來觀察因操作、組裝以及測試對封裝體造成的損傷。

X射線檢查(X-Ray):X光檢查的目的是采用非破壞性的方式探測封裝體內部的缺陷,尤其是在封裝過程中產生的缺陷,諸如外 來物質、不合適的互聯引線、晶粒粘結材料中的空洞等內部缺陷。
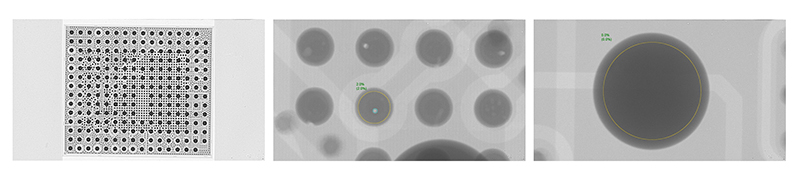
超聲掃描分析:聲學顯微術是一種先進的無損分析方法,它利用高頻的超聲波獲得物體內部和外部的高分辨率的圖像。 通過捕捉通過物體的聲波(穿透模式)或從物體反射回去的聲波(反射模式), 并將這些聲音信號轉化為數字 信號,可以獲得圖像。聲學顯微技術還可以顯示物體的內部結構和缺陷。

芯片開封+內部目檢
芯片開封Decap+OM:確認開封后的封裝體內部是否有缺陷或損傷,包括晶粒上的logo標識應與廠家資料相符/芯片頂層表面不 得有污染、異物、擦傷、劃痕、裂紋、頂針印損傷、樹枝狀結晶等/有效電路區無裂紋/die邊緣與die護圈外側邊 緣間的最小距離/Die表面鈍化層無缺損、無裂紋等。

樣品晶粒四角放大圖及KOZ width測量和晶背概貌圖(表征晶背形貌細節)。
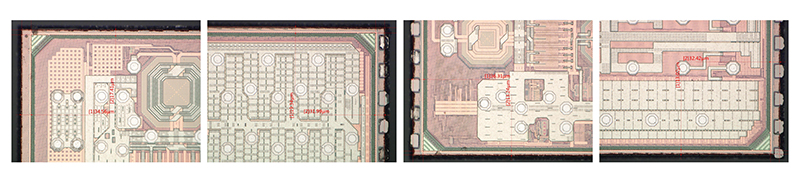
芯片開封Decap+SEM:打線區域放大圖及焊球直徑、線徑、焊球與周圍結構的間距、Bond pad opening尺寸測量。
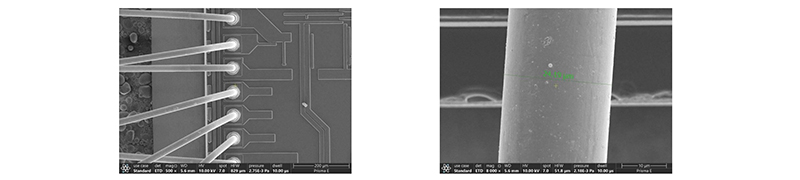
制樣鏡檢:
切片+SEM:確認芯片樣品內部結構,針對X-Ray&SAT分析異常做切片驗證。

切片+EDS:確認鍵合線及金屬層材質。
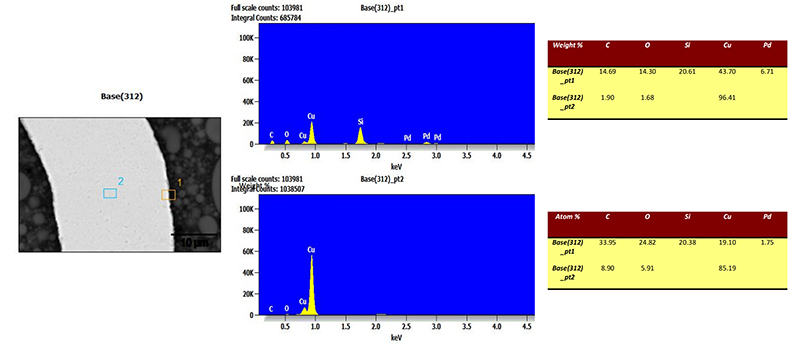
IC芯片假冒翻新:


其他測試: