TOF-SIMS介紹
————————————————————————————————————————————————————
飛行時間-二次離子質(zhì)譜儀(TOF-SIMS)是一種基于質(zhì)譜的表面分析技術(shù)。高能一次離子束(如Ga+,Bi3+, Arn+,Cs+等)轟擊樣品表面,在轟擊區(qū)域產(chǎn)生包含樣品表面成分信息的帶電離子(碎片),這些帶電離子經(jīng)過質(zhì)量分析后得到樣品表面信息。TOF-SIMS因其高靈敏度和高質(zhì)量分辨率等特性,廣泛應(yīng)用于半導(dǎo)體行業(yè)的摻雜與雜質(zhì)的分析,電子行業(yè)的痕量污染物分析,生物制藥行業(yè)等。 高能一次離子轟擊樣品表面產(chǎn)生的二次離子被提取到無場漂移管,沿既定飛行路徑到達檢測器。由于給定離子的速度與其質(zhì)量成反比,因此不同質(zhì)量的 離子的飛行時間不同。質(zhì)量越輕,到達檢測器的時間越早。通過監(jiān)測進入檢測器的離子的飛行時間可以得到樣品表面的質(zhì)譜。 |
|
TOF-SIMS儀器介紹
————————————————————————————————————————————————————
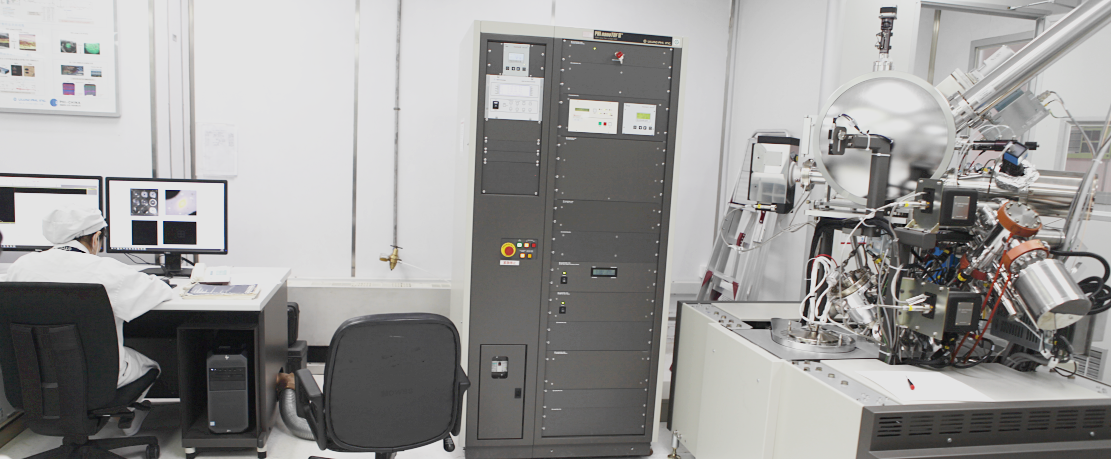
|
儀器能力
獲得的信息:元素(H~U), 同位素、 分子結(jié)構(gòu)、 化學(xué)鍵接 采集深度:1-10? 空間分辨率:0.07 μm 成分檢出限:~1ppm 深度剖析功能:具備 定量能力:需要標準品
|
TOF-SIMS應(yīng)用范圍
————————————————————————————————————————————————————
同位素分析
輕元素分析
痕量物質(zhì)的分析(ppb-ppm)
表面超薄有機污染物分析
深度剖析:超薄多層薄膜結(jié)構(gòu)分析(膜層厚度nm),特別是有機薄膜。
表面有機涂層分析(納米級)
原位分析
TOF-SIMS應(yīng)用實例
————————————————————————————————————————————————————

3D應(yīng)用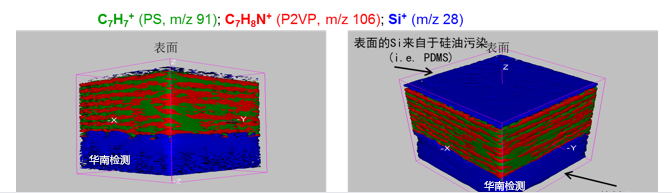
TOF-SIMS來樣要求
————————————————————————————————————————————————————
磁性材料不可分析
樣品導(dǎo)電性:無論是導(dǎo)體, 半導(dǎo)體還是絕緣樣品,都可以分析
樣品形態(tài):可對固體、液體樣品進行分析,但不能對其中的揮發(fā)性成分進行分析
樣品尺寸:常規(guī)樣品:長/寬<1cm,厚度<1cm;特殊樣品:長/寬<9cm,厚度<1cm
樣品包裝注意事項:樣品用干凈材料包裝,盡量避免接觸測試面,存放于溫濕度適宜條件下,有條件最好真空包裝
樣品制備注意事項:需測試樣品表面成分的,請不要對樣品進行擦拭、觸摸等,避免污染測試面;
測試本體成分的,可以對樣品進行破開,露出新鮮斷面
使用導(dǎo)電膠進行樣品制備時,要及時進行分析